

发布时间:2025-04-10
在半导体封装领域,如何抑制封装材料中的α粒子干扰已成为高密度芯片制造的核心挑战。近期行业内涌现出一类创新型低α材料——多面体近球形单晶α相氧化铝,其独特的物理特性为封装技术升级提供了全新思路。
α粒子的隐形威胁与封装革新
半导体器件在运行过程中可能遭遇的软性失效,往往源于封装材料中放射性杂质释放的α粒子。这类粒子穿透芯片时产生的电离效应,对高密度存储器等精密元件的稳定性构成严重威胁。尤其在动态随机存储器等高可靠性场景中,采用超低α射线封装材料已成为行业共识。
环氧模塑料作为主流封装介质,其性能优劣直接影响芯片的机械强度、散热效率及长期可靠性。传统封装体系通常采用硅基填料,但随着芯片集成度的跃升,导热性能更强的氧化铝基材料逐渐崭露头角。此类材料不仅需要具备优异的热管理能力,更需通过严格的放射性元素提纯工艺,将铀、钍等杂质含量控制在极限水平。国际半导体标准组织已为此类材料的α粒子释放量建立了系统评估体系。
类球形单晶α相氧化铝制备工艺的技术突破
尖端材料制造商通过创新工艺实现低α氧化铝的量产突破。部分企业采用气相沉积法精控材料纯度,另一些则开发了高温熔融技术优化颗粒形貌。这些工艺创新在确保材料低放射性的同时,实现了晶体结构的精密调控,为后续应用奠定基础。
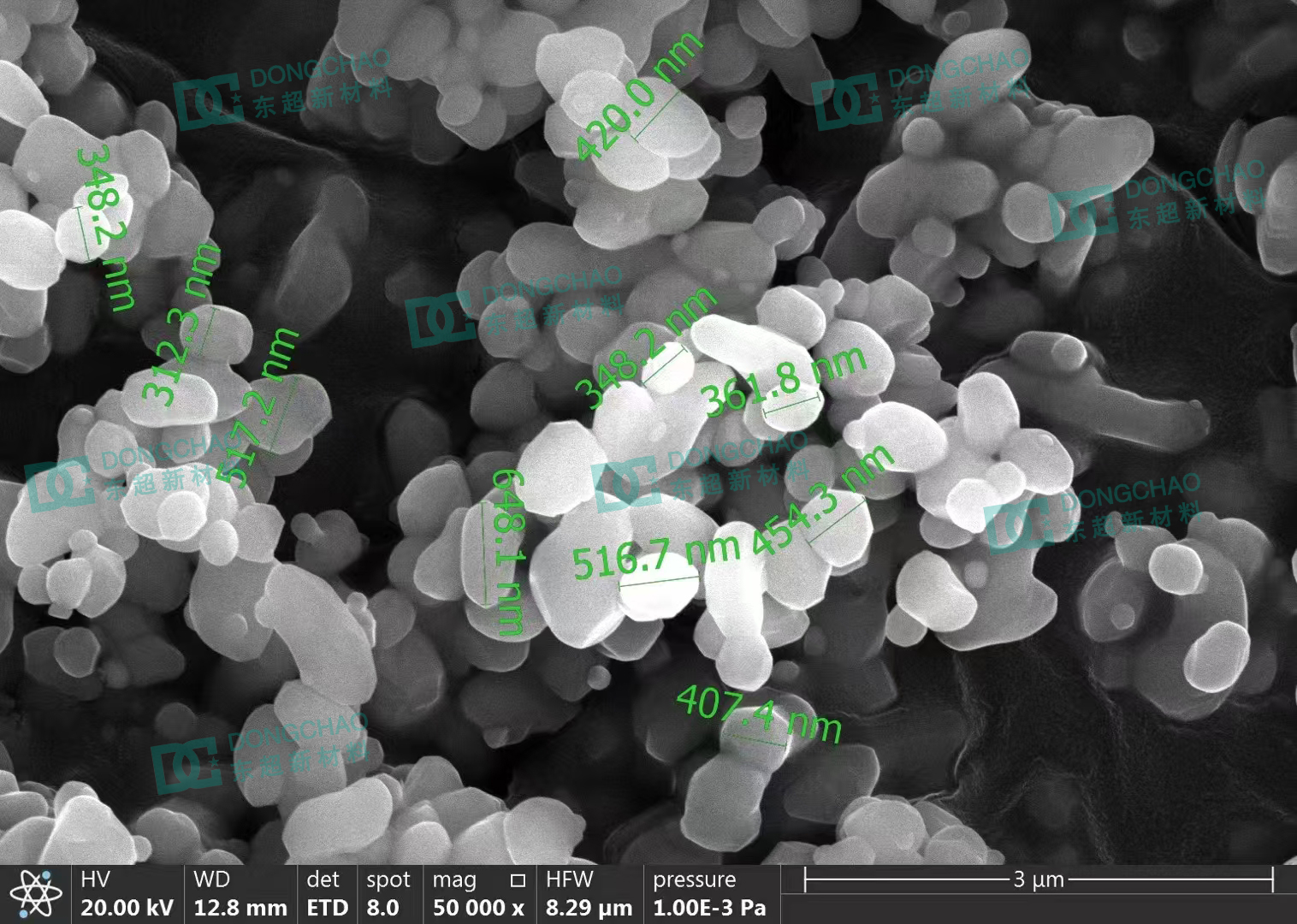
纳米类球单晶α氧化铝DCA-500NL电镜图

当前,这类创新型氧化铝材料已在高阶存储芯片封装中开展应用验证。其融合低放射性、高导热与结构稳定的综合特性,为半导体封装材料进化提供了新的技术路径。
备注:内容素材来自热管理实验室
